题记
氮化镓高电子迁移率晶体管 (GaN HEMT) 技术(或最初称为宽带隙技术)的研究和开发在 20 世纪 90 年代末开始势头强劲,与频率为 2 GHz 的横向扩散金属氧化物半导体(LDMOS)相比,其卓越的性能推动了这一技术的发展。 其中包括高功率密度和在 35V 下运行的可能性,使其成为 LDMOS 的有力竞争对手。 到 2000 年代初,GaN 在碳化硅 (SiC) 衬底上生长时获得了两种材料的相关性,这种组合可实现出色的热性能。
到 2000 年代中期,GaN HEMT 功率器件在某些微波功率放大器应用中成为 LDMOS 的有力竞争对手; 此时,针对 3G 和 4G 应用的功率密度与 LDMOS 类似的报告已经出现。 毫米波频率的研究也顺应了这一趋势。 到2010年代末期,GaN HEMT 已经足够成熟,可以在 W 波段范围内提供功率 。 如今,GaN HEMT正在成为毫米波应用的关键器件技术。 由于出色的材料特性,最近先进的 GaN 器件设计大幅提高了性能,包括高功率、高效率、可靠性和紧凑尺寸。 这些功能非常适合众多毫米波功率应用,例如适用于 5G、6G 无线网络的波束成形技术以及适用于 W 频段及以上频率的 PA MMIC。 因此,GaN将在包括5G和卫星通信在内的先进射频和毫米波应用中发挥重要作用。 热管理,尤其是使用小尺寸元件时,以及对表面和体陷阱的完全控制,将是确保所需器件可靠性的主要挑战。
优质的学习资源中心cloudioe:关注我们,持久地阅读学习,投资您自己、提升您的能力和格局,改变您的生活!我们也能帮公司企业和研发人员吸收宇宙的力量,提高研发效率,降低研发投资,找到应用灵感!
5G移动通信技术的应用

图1. 5G可以提高消费者、企业和政务服务部门的性能并实现新的应用
移动通信不断增长的数据速率和连接数量为我们的日常生活提供了令人兴奋的用户体验。 目前,无线通信前沿正在从当前的第四代(4G)转向即将到来的5G。 国际主要通信公司和制造商都在竞相展示 5G 功能和特性,同时为毫米波技术铺平道路。 宽带无线电接入和无线网络凸显了 5G 的开拓性,不仅适用于电信行业,还适用于机器人、汽车、工厂自动化、医疗保健和教育等广泛的垂直行业。 尽管 5G 的预期功能和用例广泛且多样,但 5G 部署的开始可能只会通过三种场景解决少数几个突出的用例:超可靠低延迟通信 (uRLLC)、增强型移动宽带 (Enhanced Mobile Broadband)、 和大规模机器类型通信(mMTC)。 在 5G 的应用愿景下,这些场景具有截然不同的系统级性能要求,例如延迟、移动性、用户数量和数据速率。
评估5G无线网络的关键性能指标(KPI)包括峰值数据速率、用户体验数据速率、延迟、移动性、连接密度、能源和频谱效率以及区域流量容量。 以人为本的4G和面向万物互联的5G有许多新型的网络特征。 其设计目标包括以下内容:
– 峰值数据速率至少为20 Gb/s,对于毫米波网络回传等特殊场景,是4G的10倍。
– 用户体验数据速率为0.1 Gb/s,是4G的10倍。 在热点情况下,用户体验到的数据速率预计会达到更高的值(例如室内 1 Gb/s)。
– 与4G相比,能源效率提高3倍,频谱效率提高10-100倍。
– 1 ms 的空中延迟和高达 500 km/h 的高移动性。 这将为自动驾驶等 uRLLC 场景提供可接受的服务质量 (QoS)。 – 连接密度是4G的十倍。 最高可达106台/km2,例如mMTC场景,区域流量容量可达10Mb/s/m2。
与当前的4G LTE(长期演进)网络相比,未来的增强型移动宽带 (Enhanced Mobile Broadband) 5G网络的目标是20 Gb/s的峰值数据速率,这意味着提升了10倍。 新波形以及多输入多输出 (MIMO)、波束成形和毫米波技术被认为是 5G 的关键功能,可在能源和频谱效率方面实现出色的网络性能。 由于毫米波前端模块需要支持波束赋形功能,毫米波频率下的 MIMO 对硬件设计提出了重大挑战。 这对 5G 网络高性能 PA 的开发提出了新的挑战。
5G移动通信的关键技术

图2. 5G可以提高消费者、企业和政务服务部门的性能并实现新的应用
新兴的第五代(5G)通信系统有望解锁无数新业务,并为许多行业提供增长平台。5G移动通信的关键技术要求是实现数十亿设备的泛在连接,并支持多Gbps的数据速率。目标是实现比现有移动系统大数千倍的容量。5G可以提升商用应用的性能,在增强现实、虚拟现实、混合现实应用(AR、VR、MR)、视频会议、工业自动化、自动驾驶汽车、联网医疗设备等领域实现新的用户体验和服务。为了实现5G,在硬件开发、系统架构和网络部署方面面临无数挑战。
在 5G 设计中,需要模拟前端 (AFE) 来支持多输入多输出 (MIMO) 配置中的多个发射和接收路径。图2显示了子阵列有源相控阵天线(APAA)大规模MIMO的框图。如图2所示,RF前端模块由功率放大器(PA)、低噪声放大器(LNA)和开关组成。5G 日益复杂,限制了在开发此类复杂射频子系统方面具有专业知识的制造商数量。然而,随着5G设计的成熟,越来越多的供应商正在应对AFE的设计挑战。
众所周知,RF PA的性能通常主导着整个发射机(TX)的性能,因为它的功率附加效率(PAE)决定了整个TX的功耗和散热要求。为了在厘米波/毫米波频率下增强用户体验和大规模MIMO天线,5G系统将需要更多的PA集成到射频前端模块(FEM)中,这使得5G PA的设计比4G PA更为关键。对于任何成功的商用 5G 应用,输出功率 (Pout)、线性度、成本、电路拓扑设计、PA的形状因素等都非常重要。许多其他公司也在投入大量资源来实现5G革命,其中将使用sub-6GHz频段的频率范围1(FR1)和毫米波频段的频率范围2(FR2)。
自 1990 年代该技术进入市场以来,射频功率放大器一直以横向扩散金属氧化物半导体 (LDMOS) 器件为主,尤其是在频率低于 2 GHz频率范围的应用时,因为它们成本低廉。他们最大的竞争对手是基于砷化镓(GaAs)的放大器,它更适合更高的频率,但其功率传输水平较低,成本较高。与硅和砷化镓(GaAs)半导体材料相比,氮化镓(GaN)是一种宽带化合物半导体,具有高击穿电场强度、高电子饱和速度、高导热性和低介电常数。氮化镓(GaN)将取代传统的半导体材料用于5G网络应用,例如小型基站(Small Cell),这些应用需要更高的频率、紧密的集成度和最低的实施成本。低压氮化镓(GaN)提供的效率性能将不可避免地进入手机应用中。同时氮化镓(GaN)能够在高温环境下工作,非常适合被动冷却、所有户外塔顶基站电子设备和汽车应用中。
GaN毫米波器件的目标应用
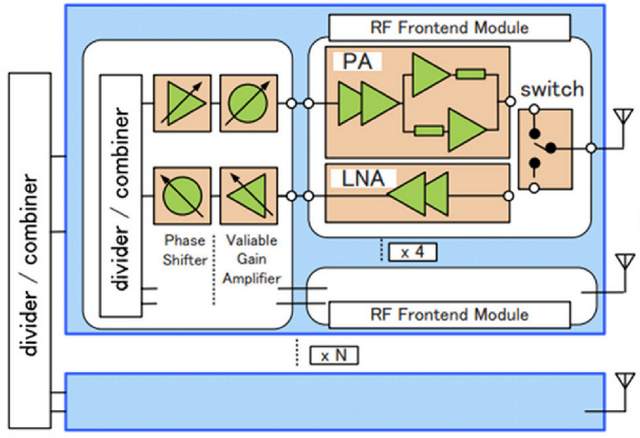
图3.子阵列APAA massive MIMO的实现框图
GaN HEMT(高电子迁移率晶体管)器件的最新改进使得各种下一代毫米波电路得以实现。 GaN 技术具有宽带隙、高饱和电子速度和更高的击穿电压,是实现高功率、高效率和宽工作带宽电路的非常有前途的候选者。 这些优势不仅对紧凑型固态 PA 有吸引力,而且对未来 5G 蜂窝通信的发射机设计也有吸引力。 图 4显示了 2022 年之前针对多种类型应用对 GaN 的临时投资。 GaN 技术投资将随着时间的推移继续增长,直至 2022 年达到 25 亿美元。这种增长的原因是 GaN 将在许多应用中发挥重要作用,GaN被视为一项战略技术。
由于 5G 对巨大流量的需求即将到来,对 GaN 功率放大器的高频需求正在上升。此外,5G技术中复杂的调制方案和拥挤的射频频谱导致对基于GaN的功率放大器的高线性度有更大的需求。此外,硅基氮化镓(GaN-on-Si)因其具有竞争力的性能而成为一种有前途的选择,这得益于其集成到提供规模经济的标准半导体工艺流程中。频率、线性度、成本和紧凑建模在决定移动通信用氮化镓(GaN)功率放大器器件的性能和竞争力方面都起着关键作用。
半导体器件制造和加工技术的最新进展已经突破了 MMIC 对于毫米波频率的限制。 在这些频率下工作的 MMIC 组件将用于提高辐射功率、通信系统接收器和雷达仪器收发器的灵敏度和性能。 第一个 MMIC 于 1976 年被报道出来,此后输出功率、增益和工作频率不断取得进展。 最近的文献表明,基于硅 (Si) 的 MMIC,例如互补金属氧化物半导体 (CMOS) 绝缘体上硅 (SOI) 堆叠 MMIC 和功率组合硅锗 (SiGe) MMIC,可以在高频率下工作。 因此,它们可以应用于需要低于 Ka 波段几瓦的高功率应用。 然而,在较高频率下,与基于 GaN 的器件相比,基于 Si 的 MMIC 无法提供必要的输出功率。
高功率放大器主要在 mmW 范围内使用基于 III-V 族材料的其他技术开发,例如砷化镓 (GaAs) 和磷化铟 (InP) HEMT。 尽管取得了优异的成就,但由于低击穿电压和相关的低漏极电压偏置操作,基于 InP 和 GaAs 的毫米波功率放大器在饱和功率水平方面也受到限制。 先进的 GaN HEMT 已在毫米波范围内展现出高功率,超过任何其他技术 5-10 倍 。 与 Si、GaAs 和 InP 材料相比,GaN 的额外优点是具有卓越的机械鲁棒性和在更高温度下工作的能力 。 GaN MMIC 彻底改变了毫米波固态功率放大器 (SSPA) 领域,并实现了以前因 SSPA 输出功率有限和行波管放大器 (TWTA) 尺寸大而无法实现的新应用。GaN 以其高输出阻抗、低输出电容以及高击穿电压而备受开发者青睐,因为这些特性带来了高效率和高功率 MMIC 性能。
宽带放大器

图4.到 2022 年针对多种类型应用的 GaN 投资
近年来,基于GaN的毫米波MMIC的应用将功率放大器的最先进性能推向了一个新的水平。 对于仪器或通信系统等许多需要集成多种服务并减少组件数量和尺寸的应用来说,覆盖较宽带宽的射频 (RF) 功率放大器将非常有益。 迄今为止,覆盖较宽频率范围的系统需要多个窄带功率放大器。 这些放大器通过开关或三工器连接。 在任一情况下,附加电路都会引入损耗,因此,这样的系统并不有利。 为了降低成本和系统复杂度,需要用覆盖多个频段的单个宽带功率放大器来代替多个放大器。 因此,基于 GaN 的宽带功率放大器 MMIC 是军事和无线通信等众多应用中采用的关键组件。 对于 5G,GaN MMIC PA 预计将广泛部署在蜂窝基站中,以减小尺寸并提高系统集成度。 因此,MMIC 的实现必须开发低损耗和紧凑的电路,以确保高效率和宽带宽。
功率放大器的性能评估基于五个关键参数:效率、输出功率、线性度、增益和带宽。 近年来,功率放大器的改进引起了重大的研究和开发。 功率放大器的最佳工作等级取决于目标线性度、效率和输出功率。 在传统工作类别(A、B、AB 和 C)中,功率放大器的工作方式类似于压控电流源。 然而,最近引起广泛关注的另一个方面是使用所谓的开关模式概念(例如 D 类、E 类和 F 类)来提高放大器效率,目标是达到 70% 甚至更高的漏极效率。
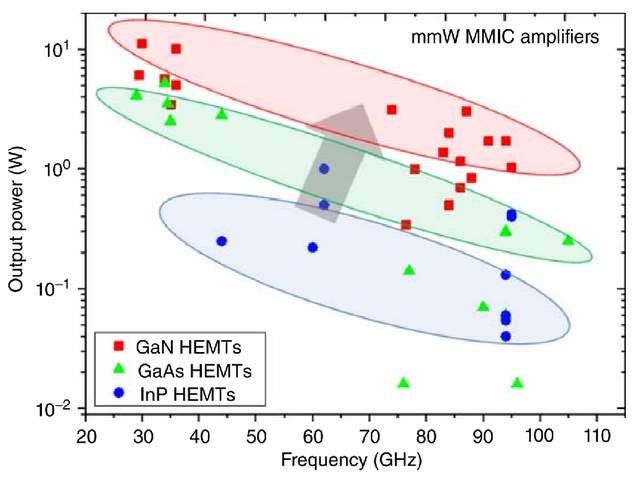
图5.基于各种半导体晶体管技术的 MMIC 放大器在 CW 操作下的输出功率
图6中的这些结果表明基于 GaN 的 PA 在提高固态功率水平同时保持宽带宽方面具有巨大潜力。 据报道,宽带 GaN MMIC 的工作频率高达 140 GHz,输出功率范围为 32–38 GHz 范围内的 10W 到 90–140 GHz 范围内的 47 mW 。 尽管这些 MMIC 产生了有吸引力的功率水平,但正如预期的那样,最高功率水平与窄得多的带宽相关。 然而,通过使用片上行波功率合成器电路技术,Quinstar 报道了使用 GaN MMIC 的几瓦输出功率,其带宽接近整个 W 频段。 另一种报道的实现高增益宽带放大器的技术是非均匀分布式功率放大器(NDPA)。 在这种情况下,放大器在 NDPA 的驱动级中使用双栅极 HEMT,从而在宽带宽下提高整个放大器的增益。 IAF 报告的 NDPA MMIC 频率范围为 6 至 37 GHz 和 8 至 42 GHz,输出功率为 1W 和 500 mW,相应的功率增益分别高于 11 和 8 dB。
氮化镓(GaN)在5G 基站中的应用
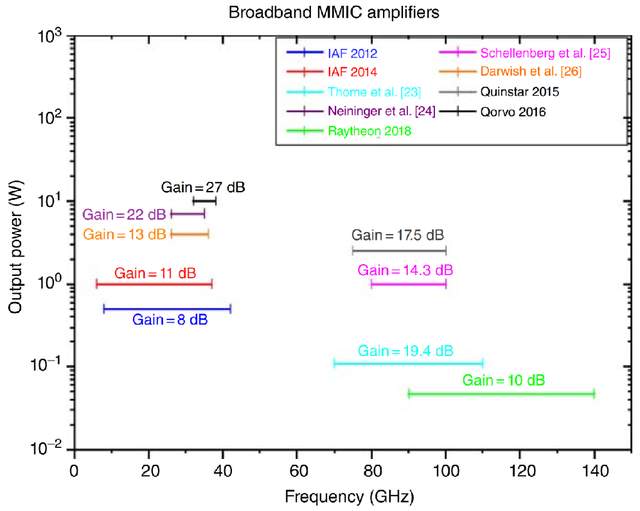
图6.宽带 MMIC 放大器的输出功率
先进的 PA 架构随着 GaN 技术的发展而不断发展,以满足越来越高的系统级要求,特别是在效率、功率水平和调制带宽方面的要求。 GaN 将超越 5G 网络应用的传统半导体材料,在恶劣环境下运行时需要更高的频率、紧密集成和最低的实施成本。 这些特性导致需要在大频率范围内实现高效率和高功率 PA 性能,从而实现低成本、大带宽和小尺寸的基站系统。
为了满足5G应用对PA的复杂要求,器件技术选择和电路配置至关重要。 5G 的几个关键方向已经出现。 反过来,硅基PA仍然在 6 GHz 以下的频率中胜出,但在更高的频率下,GaN 的吸引力越来越大。 另一方面,频谱的关键分配将决定收发器硬件的设计和实现。 然而,高数据速率的可用频谱仅限于微波范围。 这就是为什么需要毫米波频率来扩展当前的 4G 频段。 最近,在该框架中报道了各种 GaN PA。
使用具有更高带宽和更复杂方案的调制信号来实现更高的数据速率。 此外,对多频段、多模式操作下的高效率的需求也在不断增加。 Doherty 放大器、包络跟踪 (ET) 放大器和基于 GaN 的数字发射器等各种方法已经得到验证。 虽然毫米波 5G 正在开发中,但它将首先在低于 6 GHz 的 5G 系统上实现,使用相同的 MIMO 波束成形技术,但频率更低、技术上更容易实现。 5G 通信网络不仅设计用于 6 GHz 以下的频段,还设计用于 24 GHz (mmW) 以上的高频段。 许多低于 6 GHz 的 5G MIMO 系统已在 3.3、4.2 和 2.14 GHz 上进行了演示和应用 ; 在毫米波领域,已经提出了多种 GaN PA。
随着数据速率需求的不断增长,现代通信网络使用具有高峰值功率平均比 (PAR) 的高带宽调制方案,但以牺牲 PA 效率为代价。 在高 PAR 下,PA 必须在其饱和点显着回退的情况下运行,以便在 PA 输出处实现所需的线性度。 此外,必须降低 PA 的最大输出功率水平,以使整个信号处于线性区域内,从而降低效率。 解决方案是使用先进的 PA 架构,以提高 PA 效率,同时保持高线性度。 例如,基于 D 类和 S 类放大器的 Doherty、ET、异相(Outphasing)和开关模式 PA。
Doherty PA 技术采用有源负载调制,是一种很有前景的架构,可提高回退操作时的效率和线性度。 使用 GaN 技术覆盖多频段频率范围的 Doherty 放大器已被证明具有在高达 Ka 频段上实现的高效率。 此外,基于动态电源调制的ET PA在提高PA效率方面也具有竞争力。 在这种情况下,为了在回退区域保持高效率,包络放大器动态调制 RF PA 的电源电压。 这两种先进的 PA 架构将继续主导需要多频段和高效率的 5G 应用的射频和毫米波应用。 尽管如此,带宽和线性度仍然是 Doherty 和 ET PA 技术中最重要的限制之一。
为了克服这些问题,业界的研究者已经提出了几种技术,包括数字预失真(DPD)技术。 该框架的另一个最新进展是使用非线性组件 (LINC) 异相 PA 架构的线性放大,这对 5G 系统很有吸引力,因为它具有提供高效率和大峰值 PAR 信号的强大潜力 。 为了满足5G无线通信网络的毫米波、高线性度、高输出功率、大带宽和紧凑尺寸等实际需求,PA性能还有很大的改进空间。 GaN HEMT 是最适合功率放大器的器件之一,并且必将作为 5G 无线通信的宽带技术而发挥重要作用。
迈向6G的毫米波高频技术
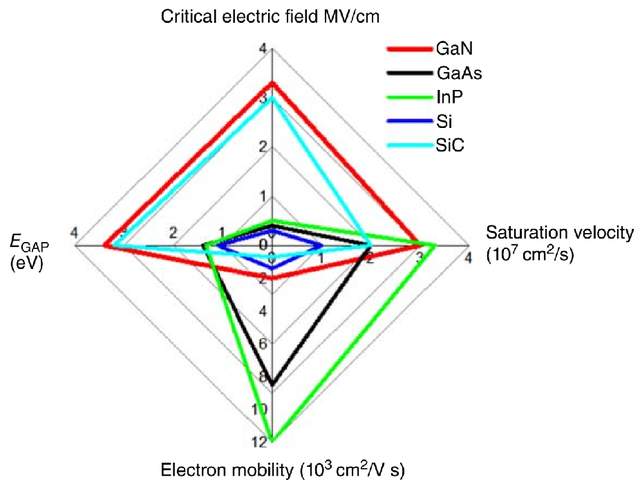
图7.毫米波半导体的材料特性
5G网络系统被定义为万物互联应用的关键。 对毫米波无线通信的研究工作和 5G 初步测试的成功确保了 5G 无线网络的商业化和首次部署在 2020 年加速推进 。 所承诺的突破性 5G 系统主要在 24 至 71 GHz 之间的高频下运行,将解决目前仅限于 6 GHz 以下频率的 4G 蜂窝通信系统中的频谱不足问题。 尽管正在上市的5G系统将支持基本的IoE应用,但无线回传、虚拟现实(VR)/增强现实(AR)和太空旅行等新应用的不断增加,使其能否满足新兴业务和需求受到质疑。 另外还有许多尚未构思的较新的潜在应用。 这些激发了人们对第六代 (6G) 网络的兴趣。
最近的调查已经确定了可能定义 6G 的关键支持技术。 未来的 6G 无线通信将在大约 10 年(2030 年)内实现,设备运行频率可达太赫兹范围。 评估6G无线网络的关键指标包括峰值数据速率为1Tb/s,它是5G的100倍,时延为10-100μs,能效比5G高10-100倍。 亚太赫兹 10 年内可达到的 6G 成熟度水平可以使该技术成为6G移动通信技术的强大推动者。
从历史上看,基于 MMIC 的半导体技术的进步带来了性能的持续改进。 与许多射频应用的其它技术相比,GaN 代表了一次飞跃。 20 世纪 90 年代初,GaN 被认为是满足高功率和高频需求的潜在解决方案。
图7显示了广泛使用的毫米波半导体的材料特性,展示了基于GaN的材料系统在高频和高功率应用中的优势。 由于其优异的性能,GaN技术被认为是一种革命性材料,其能隙更宽,达到3.4 eV,超过InP、GaAs和Si的三倍,从而允许更高的击穿电压和更高的工作电压。 2.5 × 107 cm/s 的高饱和电子速度是 GaN 的另一个吸引人的特性。 电子速度与电流密度有关; 因此,GaN能够在高电压下产生大电流。 由于功率是电压和电流的函数,因此宽能隙和高电子速度可实现理想的高功率器件。
此外,如前所述,GaN 基异质结构具有 1-2 × 103 cm2/V s 的高电子迁移率,从而实现低导通电阻。 因此,可以在高频下实现高功率附加效率(PAE)。 GaN的热导率(在1.3至2.1W/cm·K范围内)远高于GaAs和InP。 热导率是与器件功耗直接相关的关键因素。 使用约翰逊品质因数 (JFoM,Johnson figure of merit) 对各种材料进行的比较清楚地表明了 GaN HEMT 相对于同类材料的优越性。
GaN器件中的捕获效应(Trapping Effects)问题
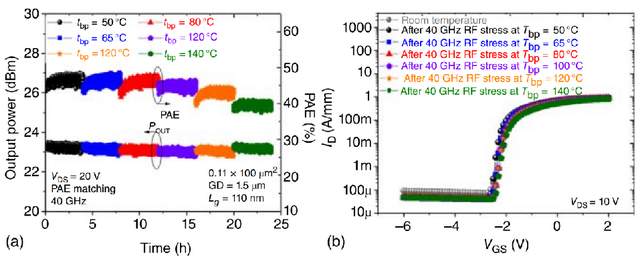
图 8
图 8 显示了在 40 GHz 下对有前景的 AlN/GaN HEMT 结构执行 RF 监测的示例,该结构的栅极长度 Lg = 110 nm,栅极至 漏极距离Lgd=1.5μm。
除了器件性能之外,相关的可靠性也至关重要。 对于在高漏极偏压下提供高性能的短器件,主要限制是由于显著的电场峰值和随后的高结温而导致的器件可靠性较差的问题。 可以指出的是,所谓的场板已在微波范围内成功实现,通过分散电场峰值来确保器件的高可靠性。 然而,这种方法实际上不能用于毫米波器件,因为高感应寄生电容会降低增益。 在技术开发的早期阶段评估可靠性至关重要。 测试通常在给定的持续时间内在特定的操作和环境条件(例如温度、电压、电流等)下进行。
对其高温条件下的可靠性和性能进行了研究。 GaN mmW HEMT 可以在高达高结温的情况下提供稳定的器件性能 。图8显示了在 40 GHz 下对有前景的 AlN/GaN HEMT 结构执行 RF 监测的示例,该结构的栅极长度 Lg = 110 nm,栅极至 漏极距离Lgd=1.5μm。 这些器件已在 V DS = 20 V 下以 4 小时为一个步骤在 24 小时内进行了高达 140 ∘C 的基板温度(对应于高于 250 ∘C 的结温)的测试。高 PAE (50%) 40 GHz 时约 3W/mm 的 POUT 保持稳定(图 8a),栅极和漏极漏电流没有增加(图 8b)。
GaN 不仅非常适合高功率和高频,而且还可以实现更小、更便宜的芯片尺寸。 迄今为止报道的 GaN MMIC 的功率密度比 GaAs MMIC 高五倍以上,尺寸更小 。 如图 9 所示,与 GaAs pHEMT(赝晶高电子迁移率晶体管)MMIC 相比,GaN MMIC 的尺寸可减少 82%,同时提供四倍以上的功率密度。 因此,由于 MMIC 和模块级别的片上组合损耗降低,GaN MMIC 可以提供更高的效率。 因此,GaN MMIC 将彻底改变毫米波 SSPA 领域,并实现以前因 SSPA 功率有限或 TWTA 尺寸大且成本高而无法实现的新应用。
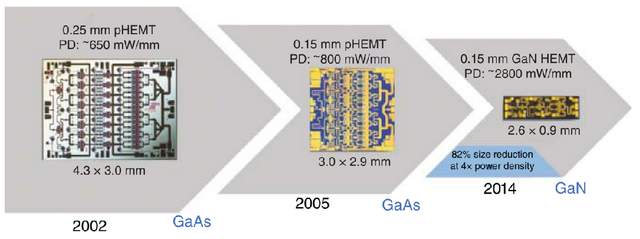
图9
图9.与 GaAs pHEMT(赝晶高电子迁移率晶体管)MMIC 相比,GaN MMIC 的尺寸可减少 82%,同时提供四倍以上的功率密度
然而,GaN HEMT仍然受到两个重要现象的困扰,特别是在减小器件尺寸时:捕获效应((trapping effects))和自加热,这会直接导致电流崩塌(current collapse)和扭结效应( kink effect),从而降低器件性能。 器件不同位置发生的捕获效应主要与生长和器件加工过程中引起的晶体缺陷有关,如图 10a 所示。 表面或缓冲液捕(buffer trapping)获通常取决于电场。 有多种技术用于评估捕获效应,例如深能级瞬态光谱测量、温度相关阈值电压分析或脉冲测量。 如图 10b 所示,AlN/GaN HEMT 器件在 V GS = +2 V 时静态漏极电压高达 25 V 时表现出相当强的俘获效应,从栅极和漏极滞后来看,这是由于 残留表面和缓冲陷阱。
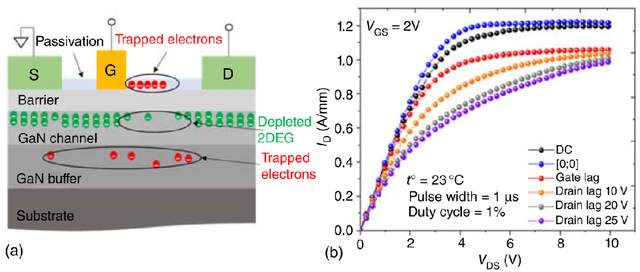
图10
图10. AlN/GaN HEMT 横截面示意图,显示电子捕获位置 (a)、不同静态偏置点下的脉冲 I D–VDS 特性:冷点:VDS0 = 0 V,VGS0 = 0 V,栅极滞后:VDS0 = 0 V,VGS0 = -6V; 和漏极滞后:VDS0 = 10–25 V,VGS0 = −6 V (b)。
捕获/去捕获机制会引起电寄生效应,例如电流崩塌和扭结效应,如图 11a 所示。 多项研究表明,电流崩塌效应与高电场下陷阱的存在和热电子注入缓冲层有关。 研究还表明,使用光瞬态测量,电流崩塌归因于栅极下方和栅极-漏极接入区域的俘获。 由于捕获机制而产生的另一个电寄生效应是扭结效应( kink effect),它会增加漏极电流,导致夹断电压向更负的电压移动。
研究者已经提出了几种解释:碰撞电离和随后的空穴积累导致表面或通道/衬底界面的变化、深能级中场相关的捕获/去捕获以及碰撞电离和深能级的综合效应通过生成的空穴诱导表面状态、缓冲或通道/基底界面深能级的改变。 其他研究报告称,GaN HEMT 中的扭结效应(kink effect)与碰撞电离以及栅极下方外延层中慢陷阱的存在有关,可能进入 GaN 缓冲区。图 11b 显示了 40 GHz 下大信号 CW 和脉冲模式之间的输出功率密度、PAE 和小信号增益与 AlN/GaN HEMT 的 V DS 函数的比较。 CW 和脉冲模式之间的性能差距,尤其是 PAE,证实了这些器件中存在陷阱。因此,有必要优化材料质量和相关工艺技术,以最大限度地减少陷阱效应现象 。
改善GaN器件中的捕获效应(Trapping Effects)问题
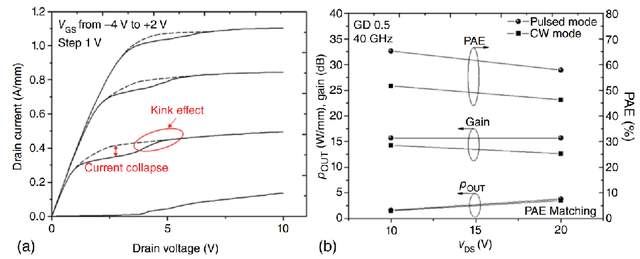
图11.I-V 特性显示由于电子俘获导致的电流崩塌和扭结效应
图 11. I-V 特性显示了由于电子俘获 (a) 和 CW(圆形)以及脉冲(方形)输出功率密度、PAE 和小信号增益而导致的电流崩塌和扭结效应,在 40 GHz 的 AlN 下作为 VDS 的函数 /GaN HEMT (b)。
为了最大限度地减少由于电子俘获而产生的寄生效应,人们做出了许多努力,例如:
– 使用氮化硅钝化(Si3N4)来改善栅极滞后(gate lag),
– 优化外延生长条件以抑制缓冲层中的深能级陷阱,
– 使用栅极场板技术来扩展栅极附近的电场或者使用原位 SiN 钝化来大幅降低表面态,是提高射频性能的关键参数。
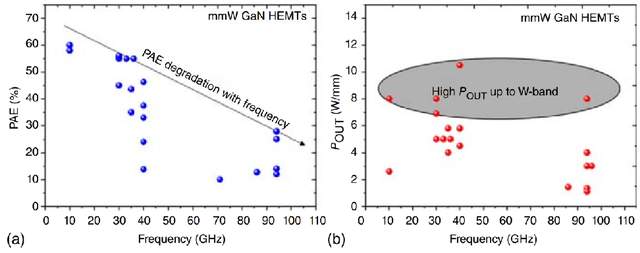
图12 GaN HEMT 的 PAE (a) 和相关输出功率密度 (POUT) (b) 与工作频率的关系。
高频操作需要积极的器件缩放,以提高 GaN HEMT 的增益和频率性能。 图 12 显示了 GaN HEMT 的 PAE 和 POUT 基准与频率的关系。 据报道,Q 波段GaN HEMT 的效率高达 60%,POUT 高达 8W/mm 。 然而,在较高频率下,GaN HEMT 的效率仍然受到限制,主要是因为增益不足。 在 W 频段,迄今为止报道的最高 PAE 为 27.8% 。 如图 12 所示,PAE 随着频率的升高而降低,而 POUT 保持在 8W/mm 以上(图 12b)。 毫米波氮化镓器件目前面临的主要挑战是在高频下保持高 PAE 以及强大的鲁棒性。
除了捕获增强和有限的 PAE 之外,由于栅极到漏极距离的减小,器件尺寸缩小还会直接影响击穿电压 (VBK) 。 图 13 显示了不同 Lgd 下三端击穿电压与 Lg 的函数关系。 该图表明 Lgd 对击穿电压的影响比 Lg 大。 因此,通过使用适当的器件设计,短器件仍然可以保持高击穿电压。
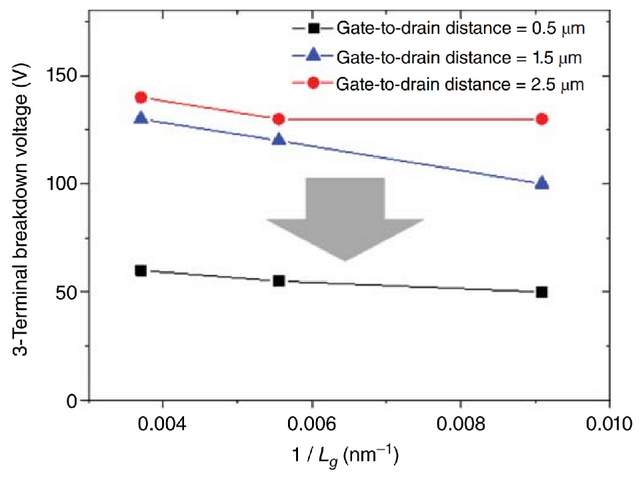
图13.AlN/GaN HEMT 的 3 端口击穿电压与栅极长度和栅极至漏极距离(0.5 和 1.5 μm)的函数关系
如今,GaN HEMT 因其固有特性而成为高功率毫米波应用中最具吸引力的电子器件。 高功率和高频 GaN HEMT 性能在毫米瓦范围内不断提高。 然而,鲁棒性和随后的可靠性仍在研究中,因为规模化的材料和器件都需要表现出高稳定性、可重复性和均匀性。
射频器件的GaN特定材料系统
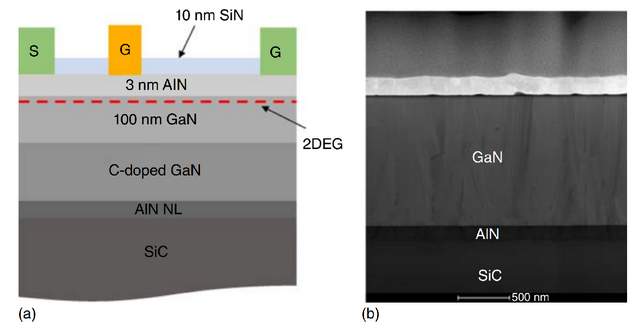
图14. MOCVD 生长的具有 3 nm AlN 势垒的 AlN/GaN/SiC 的横截面 (a) 和透射电子显微镜 (TEM) (b)。
基于 III 族氮化物材料的 GaN HEMT 外延异质结构由宽带隙势垒层(AlN、InAlN、InAlGaN 或 AlGaN)、GaN 沟道和使用金属有机化学气相沉积(MOCVD)或分子束外延(MBE)在衬底顶部生长的基于 GaN 的缓冲层组成。 GaN 基 HEMT 通常从下到上按如下方式生长:
– 成核层:通常基于 AlN,这对于适应缓冲层和衬底之间的晶格失配至关重要,从而实现高质量的 GaN 异质外延。
– GaN 缓冲层:应具有高质量,以避免深陷阱能级,并通过使用背势垒或按顺序掺入碳 (C) 或铁 (Fe) 等受主型掺杂剂,将电子高度限制在沟道中以增加电阻率。
– GaN 沟道:通常未掺杂,以实现高电子传输质量,沟道厚度是电子限制和俘获效应之间权衡的一部分。
– 势垒层:基于 AlGaN 的微波器件,最好是毫米波范围的超薄富铝材料,以避免栅极凹陷,从而损害器件的可靠性。 厚度和合金成分是机械应变和压电极化的关键参数,也定义了二维电子气体(2DEG)的密度。
– SiN 盖层:能够防止异质界面富铝势垒/GaN 沟道的应力松弛,并钝化表面态,以减少 DC(直流)到 RF的频率色散。
图 14a 显示了 AlN/GaN HEMT 横截面的示例,由 10 nm SiN 盖层、3 nm AlN 超薄势垒层、100 nm GaN 沟道、碳掺杂 GaN 缓冲层和生长在 SiC 衬底上的 AlN 成核层组成。 图 14b 显示了通过 MOCVD 生长的这种结构的透射电子显微镜 (TEM)。当低的位错密度。

图15.不同阻挡层的 2DEG 特性。
GaN器件设计的关键工艺步骤
为了增强高频性能,需要对 GaN HEMT 器件进行微缩。这些优化不仅需要外延结构,还需要一些工艺步骤,例如欧姆接触和栅极模块。 通过使用较短的栅极长度来减少电子渡越时间; 然而,应保持高于 15 的高纵横比 Lg /a(栅极长度/栅极至沟道距离)以及高载流子密度 Ns 。 这样可以防止短沟道效应,同时提高由以下方程定义的 Ft/Fmax 比率:

其中 gm、Cgs、Cgd、Rg 和 Rds 分别是跨导、栅源电容、栅漏电容、栅极电阻和漏源电阻。
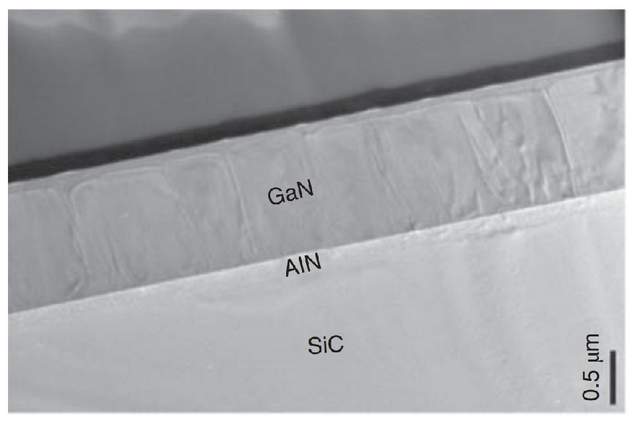
图16. 在 SiC 上生长的 GaN 的 TEM 图像。
为了提高Fmax,需要优化包括Ft和寄生元件(例如Rg和Cgd)在内的每个参数。 经过研究界的众多努力,迄今为止报告的最佳 Ft 和 Fmax 约为 450 GHz(图 17)。 这些性能是通过 T 形栅极、n+-GaN 欧姆接触再生长、自对准栅极工艺和垂直缩放外延等创新器件技术实现的。
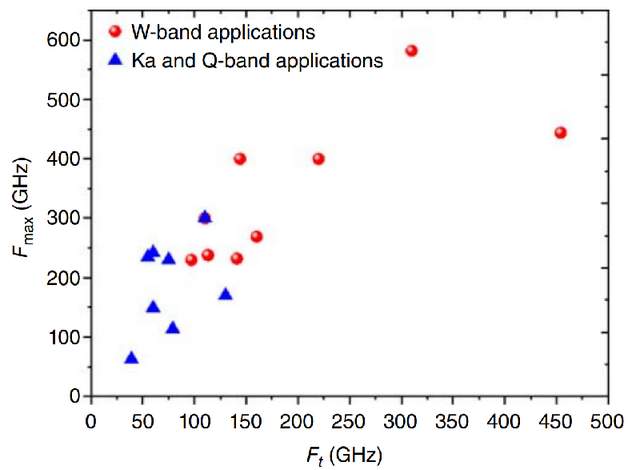
图17.最大振荡频率 (Fmax) 作为 GaN HEMT 截止频率 (Ft) 的函数。
T形栅极广泛用于在减小栅极长度时实现低栅极电阻和低寄生电容。 对于较短的器件,寄生元件变得至关重要。 事实上,频率性能目前主要受到短沟道效应和寄生元件的限制。 图 18a 显示了 GaN HEMT 的示意性横截面,说明了寄生元件和减少栅极长度的 T 栅极的优点,这基本上能够实现高射频性能。 此外,栅极长度的减小导致 Ft 显着增加,高达 450 GHz(栅极长度为 40 nm),如图 18b 所示。
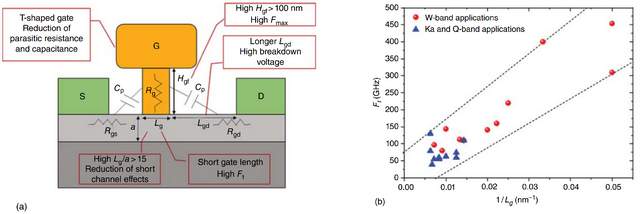
图18. T型栅极GaN HEMT的横截面 (a) 以及 GaN HEMT 的截止频率 (Ft) 与栅极长度 (Lg) 的关系 (b)。
对于毫米波应用,必须具有低接触电阻,以最大限度地减少总寄生电阻并提高器件性能。 然而,由于III族氮化物HEMT异质结构的宽带隙,很难实现低接触电阻。 此外,阻挡层的高电势,特别是当使用高Al含量时,可能导致高接触电阻。 传统的平面欧姆接触是最简单且低成本的方法,其通过将复杂的金属堆叠合金化,然后在最佳温度下退火来形成。 然而,高温退火通常会导致严重的横向欧姆金属扩散以及粗糙的金属表面。 典型的接触电阻约为 0.25–0.5 Ω mm,导致寄生电阻与器件尺寸成正比。为了成功降低接触电阻,已经研究了几种方法,例如凹进欧姆接触可实现更低的温度,从而实现更好的接触定义、金属化前的离子注入、表面处理和再生欧姆 通过MBE技术进行接触。
在这些方法中,再生 n+-GaN 欧姆接触是最小化寄生接入电阻最有前途的技术。 欧姆接触再生方法可以实现 n+-GaN 和 2DEG 层之间的直接接触,从而实现低界面电阻 。 研究者已证明接触电阻非常低。 正如预期的那样,高电子迁移率和高片载流子密度的结合降低了需要减小栅源距离的存取电阻,从而实现优异的器件性能。 这使得这种设计对于毫米波应用具有吸引力。
各种GaN器件

图 19 Ga 极性和 N 极性 HEMT 的器件横截面示意图。
N极性GaN HEMT
传统的 GaN HEMT 通常采用 Ga 极性取向,其中 2DEG 形成在势垒层/沟道界面处,而极性在 N 极性异质结构中反转,如图19所示。 N 极性结构具有多种优点,例如由于异质界面上方诱导的 2DEG 而具有低接触电阻,以及由于沟道下方的背势垒而具有出色的电子限制。
N极性GaN 器件的开发以及加州大学圣塔芭芭拉分校 (UCSB)维内克等人报告的最新结果显示了毫米波功率应用的巨大改进潜力。 据报道,使用带有深栅极凹槽的 N 极 GaN 帽 MISHEMT(金属绝缘高电子迁移率晶体管)以控制色散,在 94 GHz 时输出功率密度为 6.7W/mm,PAE 为 14.4%。 Romanczyk 等人使用自对准门进行凹进。 展示了高击穿电压和8W/mm的高功率密度,以及 94 GHz 下 28% 的 PAE。 可以注意到,该配置系统在恶劣条件下的器件的可靠性仍然需要证明。
AlN基器件性能

图20. AlN/GaN HEMT HRL Gen-IV 的外延结构 (a) 和示意性横截面 (b)
图20显示了休斯研究实验室 (HRL) 4G 非对称自对准 T 栅 GaN HEMT 的外延结构和示意性横截面。 栅极长度为20 nm,采用欧姆接触再生长技术,允许n+-GaN与2DEG直接接触,从而实现0.026 Ω mm的极低界面电阻。 使用超薄亚 5 nm AlN 势垒,可提供高电子密度 nS,同时保持高纵横比 Lg /a。 Lgs = 30 nm 和 Lgd = 80 nm 的非对称自对准栅极可实现高速且击穿电压为 17 V。这可实现高 RF 性能,其 Ft 为 454 GHz,Fmax 为 444 GHz。 栅极长度为 40 nm 的同一器件在 W 波段实现了高大信号性能。 输出功率为1.37W,83 GHz 时 PAE 为 27% 。 此外,梯度沟道 AlGaN/GaN HEMT 表现出在毫米波范围内工作的巨大潜力。 30 GHz 大信号测量显示出 72% 的优异 PAE,输出功率密度为 2W/mm。
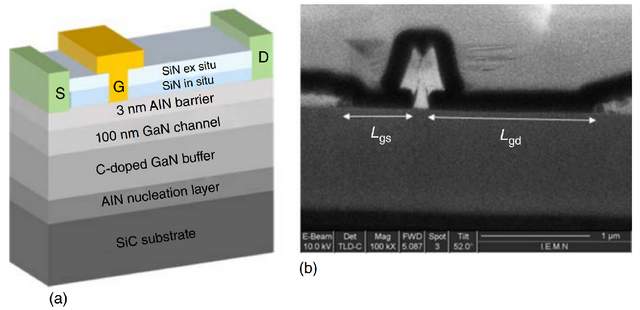
图21 AlN/GaN HEMT 的横截面示意图 (a) 和 110 nm T型栅极的聚焦离子束 (FIB) 视图 (b)
图 21a 表示基于 GaN/SiC 衬底上生长的 3 nm AlN 势垒的 AlN/GaN HEMT 结构的示意性横截面。 HEMT 覆盖有 10 nm 的原位 SiN 层,既可用作早期钝化,又可减少捕获效应。 图 21b 中所示的 T 栅极长度为 110 nm,三种不同的 Lgd 分别为 0.5、1.5 和 2.5 μm,分别产生 50、100 和 130 V 的高击穿电压。 当 Lg = 110 nm 且 Lgd = 0.5 μm 时,Vds = 20 V 时可实现 63/300 GHz 的 Ft/Fmax。
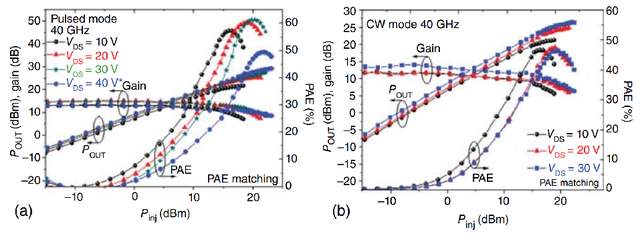
图22
图22. 2 × 50 μm AlN/GaN HEMT(Lg = 110 nm,GD = 1.5 μm)在 VDS = 10、20、30 和 40 V* 时的脉冲 (a) 和 CW (b) 功率性能。 * 表示仅功率匹配。
Ft/Fmax 比率接近 5 归因于非常有利的纵横比:栅极长度/栅极到沟道距离 (>25)。 已经在 Q 波段和 W 波段进行了大信号表征。 图 22a 显示了 2 × 50 μm 晶体管在 40 GHz 时的典型脉冲功率性能,Lgd = 1.5 μm,饱和输出功率为 5.3W/mm,峰值 PAE 高于 60%(@Vds = 30 V) ;约为 50% Vds = 40 V 时的饱和输出功率为 8.3W/mm。尽管存在残余捕获效应,但在 CW 模式下高达 Vds = 40 V 时仍可获得约 50% 的高 PAE,如图 22b 所示。 此外,还在相同的设备上进行了 94 GHz 连续波大信号表征。 当 Vds = 20 V 时,可获得 4W/mm 的高输出功率,PAE 为 14.3%(图23)。

图23
图23. AlN/GaN HEMT 2 × 25 μm 的 CW 功率性能,其中 Lg = 110 nm,GD = 0.5 μm,VDS = 20 V。
InAlGaN基器件性能
图24显示了富士通 80 nm 栅长 InAlGaN/GaN HEMT 技术的横截面。 InAlGaN势垒用于避免表面凹坑的形成,从而与三元InAlN相比降低了栅极漏电流(Ig),这是提高击穿电压和器件可靠性所必需的。 此外,InAlGaN 势垒以其高 2DEG 密度和高电子迁移率而闻名。 采用双层 SiN 钝化层来消除电流崩塌。 采用偏置悬垂栅极来降低电场而不降低高频性能。 96 GHz 下的负载牵引测量显示,在脉冲模式操作下,Vds = 20 V 时具有 3.0W/mm 的高输出功率密度。
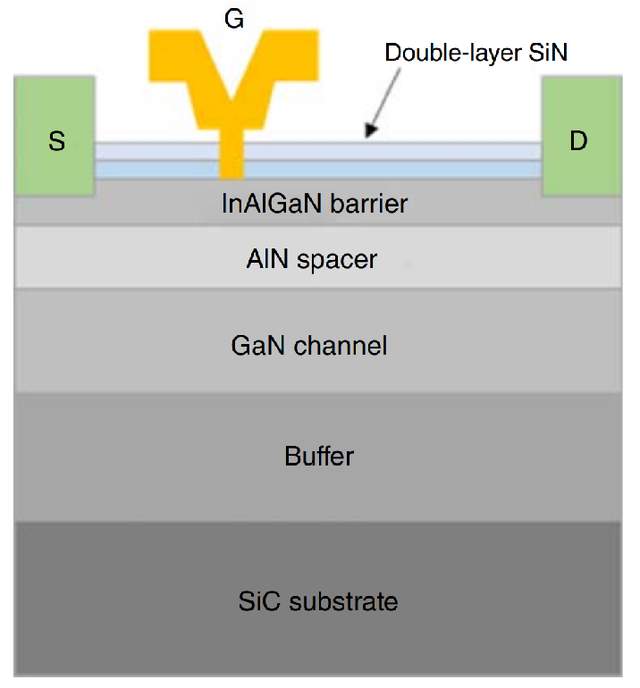
图 24 InAlGaN/GaN HEMT 的器件横截面。
此外,改进的 80 nm 栅极长度 InAlGaN/GaN HEMT 在 S 到 W 频段的宽频率范围内展示了高功率工作的性能,使用再生 n+-GaN 接触层和 InGaN 背势垒来减少断态漏极漏电流, 和AlGaN间隔层以实现接近2×1013 cm^−2的高2DEG密度。 此外,研究者还引入了金刚石散热器,以降低热阻并进一步提高输出功率密度。该InAlGaN/GaN MMIC放大器的最大脉冲输出功率密度在94 GHz时为4.5W/mm。 该功率放大器旨在用于毫米波无线回程通信中。
图 25 显示了毫米波范围直至 W 波段的 GaN HEMT 的 PAE 基准与 POUT 的函数关系。 2005 年,T. Palacios 等人报告使用 AlGaN/GaN HEMT 技术(Lg = 160 nm)创下了 10.5W/mm 的 Q 波段 POUT 记录,在 40 GHz 时 PAE 为 33%,其中 PAE 受到限制主要是因为其只有 6 dB 的线性增益。据报道,J.S. Moon等人栅极凹进和场镀 AlGaN/GaN HEMT 在 30 GHz 下的 POUT 为 5.7W/mm,PAE 为 45% 。 同样在 40 GHz 下,F. Medjdoub 等人。 在脉冲模式 AlN/GaN HEMT 中,VDS = 10 V 时具有 65% 的出色 PAE,VDS = 40 V 时具有 8.3W/mm 的高 POUT。 因此,与其他技术相比,GaN HEMT 可以实现高达 W 波段甚至更高波段的更高效率和 POUT。 为了满足 W 波段要求,例如短栅极长度(深低于 100 nm)、高 Ft/Fmax 和低接触电阻,研究人员做出了许多努力。
HRL 的Micovic等人于 2006 年报道了业界第一个具有高性能的 W 波段 GaN 晶体管(14% 的效率和 2.1W/mm POUT)。
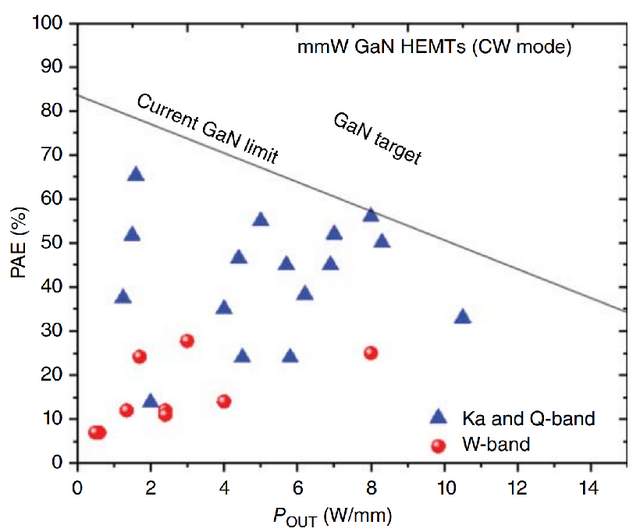
图25. 作为 mmW GaN HEMT 的 POUT 函数的PAE 基准
富士通实验室的Mikiyama等人开发了 80 nm 肖特基栅 InAlGaN/GaN HEMT,可在 96 GHz 下提供超过 3W/mm 的高功率密度 。 最近,F. Medjdoub 等人使用 AlN/GaN HEMT 技术展示了在 94 GHz 下最先进的 4W/mm POUT 和 14% 的 PAE 。 尽管这些传统的 GaN HEMT 结构是在 Ga 极异质结构上开发的,但 UCSB 最近的研究表明 N 极异质结构的出现,在 94 GHz 下提供 28% 的效率和 8W/mm 的 POUT。 可以指出的是,最佳的技术选择不仅基于性能,还基于器件在恶劣条件下的可靠性。 这将在不久的将来决定 GaN 基结构最适合毫米波应用的频段。
MMIC功率放大器

图26. 通信基站中 RF 发送/接收的示意图示例。
基于 III-V 族半导体技术的 MMIC 是满足毫米波应用要求的关键构建模块之一。 单片意味着完整的电路构建在单片半导体材料(例如 GaAs、InP、SiGe 或 GaN)上,从而形成高度集成且紧凑的器件。 尽管迄今为止业界已经报道了基于 GaAs 和 InP 的高性能毫米波 MMIC,但毫米波应用不断增长的带宽和功率需求受到这些传统半导体技术的限制。 GaN 是满足蜂窝通信和卫星通信应用的射频毫米波发射机要求的潜在解决方案。
例如,GaN器件由于其低噪声性能和鲁棒性而被用于恶劣环境的接收机应用。因此,基于GaN的器件可以涵盖任何MMIC功能,例如混频、低噪声放大、功率放大和高频开关。 图26显示了无线通信中 RF 发送和接收模块的典型元件示例。 发送/接收模块内部有两个关键组件,即 PA 和低噪声放大器 (LNA)。 除了这些组件之外,毫米波模块中还集成了不同的发射/接收功能,包括振荡器、滤波器、线性混频器、转换器和射频开关。
毫米波 MMIC 系统不仅需要提供高性能,还需要提供低成本和紧凑的尺寸。 除了有源器件外,标准无源器件(例如金属-绝缘体-金属(MIM)电容器、金属蒸发薄膜电阻器、体电阻器和通孔)也用于电路实现。 许多代工厂使用特定技术来实现 MMIC,例如接地共面波导 (GCPW)、微带传输线技术和用于 3D 互连的铜镶嵌多层工艺。 微带传输线主要用于 MMIC,并且在较高频率下变得更加重要。 用于 3D 互连的铜镶嵌多层工艺可提供高功率、高电流和低损耗的无源元件。 GCPW 允许低电感接地连接。 此外,共面波导 (CPW) 在宽带应用中比微带技术具有更低的色散,并且由于没有孔和背面处理,因此制造简单且成本更低,这有利于毫米波工作。
业界针对毫米波应用功率放大器和电路设计进行了广泛的研究。 下一代功率 MMIC 面临的主要挑战是实现至少 100 GHz 频率的高输出功率并结合高 PAE 以降低功耗。
适用于功率放大器 GaN MMIC 的 A 类、A/B 类和 C 类放大器:对于模拟设计,功率放大器分为线性 A 类和非线性 A/B 类和 C 类。 每个类别的放大器都有其优点和缺点,因为它们通常会产生参数权衡。 A类放大器操作是提供高功率密度和更好线性度但效率较低的放大器类别。 事实上,在 A 类中,静态漏极电流固定为最大漏极电流的一半,导致高功率密度,从而导致显著的功耗即较低的效率。 A/B 类操作相当流行。 静态漏极电流被设置为与线性度和效率之间的权衡相对应的最佳值。 最后,C 类操作也受到线性度的限制,它通常用于窄带应用、驱动放大器和整流器模式以提高效率。
适用于开关放大器 GaN MMIC 的 D、E 和 F 类放大器:开关模式 GaN 放大器采用 D、E 和 F 类操作以提高效率。 D 类操作通常用于低频操作的放大器。 E 类放大器旨在减少射频开关期间的功率损耗。 理想的 E 类放大器是一种开关模式电路,它将零耗散功率与零电压开关和电压开关的零导数结合起来 。 E类对应于高效调谐开关功率放大器。 在 F 类放大器中,开发了谐波调谐技术,以进一步提高 A 类和 A/B 类放大器设计的性能。 因此,F类放大器可以工作在更高的频率,但受到电路复杂性和调谐要求的限制。
射频氮化镓市场分析

图27.RF GaN的市场规模
- 2023 年射频氮化镓(GaN)市场规模估计为 10 亿美元,预计到 2028 年将达到 33.9 亿美元,在预测期间(2023-2028 年)以 18.76% 的复合年增长率增长。
- 由于射频氮化镓在各种实时连接设备和应用中使用的好处,预计更多行业将使用物联网 (IoT) 技术,预计将推动市场增长。随着氮化镓技术的不断发展,氮化镓可在更复杂的应用中实现更高的频率,例如相控阵、雷达和有线电视基站收发信台 (CATV)、甚小孔径终端 (VSAT) 和国防通信。
- 射频氮化镓在无线基础设施中发挥着关键作用,可提高效率并扩展带宽,以支持不断提高的数据传输速度。射频氮化镓市场主要受到5G采用率的提高和无线通信的进步的推动。电信运营商也可以从氮化镓功率晶体管的使用增加中受益。
- 射频氮化镓在电动汽车中的日益普及也是推动该市场需求的主要因素之一。碳化硅器件用于电动公共汽车、出租车、卡车和乘用车的车载电池充电器。此外,越来越多的政府法律有利于电动汽车市场,刺激了射频氮化镓市场的需求。
- 制造自动驾驶汽车和无人机所需的基础设施是增加对射频氮化镓技术需求的另一个因素。因此,在预测期内,用于各种应用(尤其是军事和国防)的自动驾驶汽车和无人机的采用和开发预计将进一步增加射频氮化镓器件的采用。
- 氮化镓固有的材料优势带来了一些相关的制造挑战,包括器件加工和封装的成本和优化。其他问题包括电荷捕获和电流崩溃,需要解决这些问题才能提高这些器件的采用率。尽管基于射频氮化镓的器件(性能和良率)已经取得了重大改进,但仍存在一些障碍,阻止碳化硅氮化镓(GaN-on-SiC)进入主流应用(即在无线电信基站或CATV中)。
- 根据印度电子和半导体协会的数据,印度半导体元件市场的复合年增长率为 10.1%(2018-2025 年),到 2025 年将达到 323.5 亿美元。该国是全球研发中心的重要目的地。因此,印度政府正在进行的“印度制造”计划预计将导致对半导体市场的重大投资。印度政府的此类举措将利用射频氮化镓市场。
- 2022年2月,氮化镓集成电路(IC)供应商纳微半导体宣布参加中国国际金融股份有限公司(中金公司)投资者大会。该公司专有的氮化镓功率IC将氮化镓功率和氮化镓驱动、控制和保护集成在单个SMT封装中。这种参与将利用该地区的氮化镓市场。
- 由于投资者对开发支持5G技术的基础设施的兴趣日益浓厚,预计亚太地区对射频GaN的需求将增加。例如,根据 GSMA 的数据,到 2025 年,亚太地区移动运营商的支出预计将超过 4000 亿美元,其中 3310 亿美元将用于 5G 部署。
- 随着中国从制造业经济转向创新驱动型经济,中国射频氮化镓公司的增长是更广泛趋势的一部分。中国市场对商用无线电信应用的需求呈爆炸式增长,中国公司已经在开发下一代电信网络。
- 此外,2021 年 12 月,印度理工学院坎普尔分校的研究人员开发了一种高性能、行业标准的铝氮化镓 (AlGaN) 高电子迁移率晶体管 (HEMT) 模型。该模型提供了一种简单的设计方法,可用于制造高功率射频电路。射频电路包括用于无线传输的放大器和开关,在航空航天和国防应用中非常有用。研究人员的不断创新将推动该地区射频氮化镓的市场增长。
影响射频氮化镓市场的主要市场趋势和行业动态
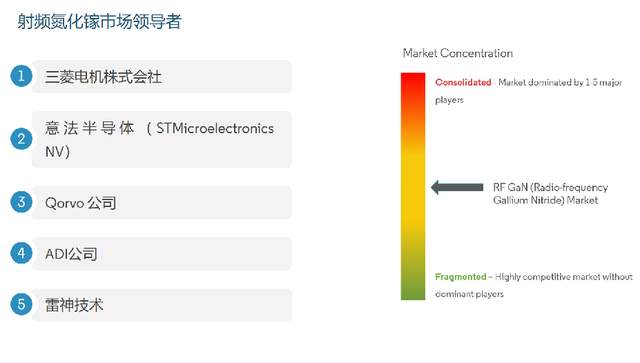
图28.RF GaN的市场领导者
5G实施的进步推动了电信基础设施领域的强劲需求:
- 电信行业作为全球数字化的主要驱动力和市场环境全面变化的行业,被视为数字化转型技术的主要用户。电信行业在互操作性和技术方面的投资促进了整个全球经济中资本和信息流动的范式转变,为整个行业出现全新的商业模式提供了基石。
- 5G技术有望彻底改变各种宽带服务领域,并实现不同终端用户垂直领域的连接。推动氮化镓市场份额的主要因素是移动用户的增加、在线视频内容的流媒体、5G 基础设施以及使用 5G 的各种物联网应用。
- 2022年5G用户数量达到4亿。随着全球 5G 技术推广的大幅增长,预计对射频 GaN 技术的需求将会增加。
- 2022 年 5 月,意法半导体 (ST)和电信、工业、国防和数据中心行业半导体产品供应商 MACOM Technology Solutions Holdings (MACOM) 宣布生产射频硅基氮化镓 (RF GaN-on-Si) 原型。凭借这一成功,意法半导体和MACOM将继续合作并扩大合作关系。意法半导体和MACOM正在开发的硅基氮化镓技术有望通过集成到标准半导体工艺流程中,提供具有竞争力的性能和显著的规模经济。
- Qorvo 是 2G、3G 和 4G 基站制造商的 RF 解决方案供应商之一。它在市场上具有独特的优势,可支持sub-6 GHz和cmWave/mmWave无线基础设施的开发。Qorvo 一直在投资涵盖相关 5G 频段(如 3.5、4.8 和 28 以及 39GHz)的产品解决方案,以服务市场,主要是为了实现 5G。
- 5G 基础设施中对密集、小型天线阵列的需求导致射频 (RF) 系统的电源和热管理面临关键挑战。凭借其改进的宽带性能、效率和功率密度,氮化镓器件为应对这些挑战的更紧凑的解决方案提供了潜力。
射频氮化镓行业概况:
- 由于雷神技术公司、STM微电子等一些主要参与者的存在,射频氮化镓市场参与者之间的竞争非常激烈。他们不断创新产品的能力使他们能够获得优于其他参与者的竞争优势。通过研发、战略合作伙伴关系和并购,这些参与者已经能够在市场上站稳脚跟。
- 2022 年 6 月,作为美国国防部 (DoD) 的先进集成互连和制造增长 RF 项目(也称为 STARRY NITE),Qorvo 被美国国防部 (DoD) 选中,作为美国国防研究与工程部副部长办公室 (OUSD R&E) 微电子路线图的一部分,继续推进面向国内最先进的 (SOTA) 射频 GaN 的高级集成互连和制造增长计划。该计划旨在与国防部的先进封装生态系统保持一致,开发和成熟国内开放式 SOTA 射频 GaN 代工厂。
- 2022年5月,意法半导体(STMicroelectronics)与工业、电信、国防和数据中心行业半导体产品的重要供应商MACOM Technology Solutions Holdings Inc.宣布成功生产RF GaN on Silicon (RF Gan-on-Si)原型。凭借这一成就,意法半导体和MACOM将继续合作并加强双方的合作关系。
射频氮化镓(GaN)市场资讯

图29. 5G 小区之间的连接规划
- 2022 年 9 月:MaxLinear Inc. 和 RFHIC 宣布合作,为 5G 宏蜂窝无线电提供生产就绪的 400MHz 功率放大器解决方案,利用 MaxLinear MaxLIN 数字预失真和波峰因数降低技术来优化 RFHIC 最新的 ID-400W 系列 GaN 射频晶体管的性能。将RFHIC的双反向GaN RF晶体管ID41411DR与MaxLIN DPD相结合,并将其作为预先验证的解决方案提供,将使无线接入网络(RAN)产品开发人员能够快速为全球所有5G中频段部署提供超宽带400MHz宏PA,并具有高功率效率和低辐射。
- 2022 年 6 月:Integra 宣布在其 100 V 射频 GaN 产品线中再推出 7 款功率水平高达 5 kW 的器件,用于航空电子、定向能、电子战、雷达和科学应用领域。这些产品使用 Integra 的 100 V 射频 GaN 技术,该技术旨在在单个晶体管中提供尽可能高的功率和效率,同时保持稳定的工作结温。
- 2023 年 4 月:HRL Laboratories 旨在基于传统硅半导体制造技术在氮化镓 MMIC 中实现前所未有的高频性能:RL Laboratories 的 ENIGMA 项目将最先进的硅多金属后端工艺与氮化镓晶体管单片集成,用于下一代单片微波集成电路中。HRL Laboratories, LLC 正在开发由美国国防高级研究计划局 (DARPA) 资助的高效 GaN 集成 G 波段单片阵列 (ENIGMA) 项目。ENIGMA将解决化合物半导体单片微波集成电路(MMIC)行业与硅射频集成电路(RFIC)行业之间的技术差距。
- 3DGaNTM(氮化镓)创新者Finwave Semiconductor宣布获得1220万美元的A轮融资,由Fine Structure Ventures领投,Citta Capital、Soitec、Safar Partners和Alumni Ventures参投。在A轮融资之前,美国能源部高级研究计划局-能源(ARPA-E)Scaleup(为具有未开发潜力的领先能源技术播种关键进展)赠款提供了430万美元的联邦资金,以帮助将公司的技术投入批量生产。这笔资金将用于扩大公司的团队、产品开发活动和实验室设施,所有这些都是为了推进Finwave的使命,即通过下一代3DGaN FinFET技术彻底改变5G通信的未来。高性能硅基氮化镓(GaN-on-Si)带来了一种新的选择,可以使5G毫米波更加实用。在毫米波频率下,硅基氮化镓放大器优于硅RFSOI MOSFET、砷化镓pHEMT或SiGe器件等替代解决方案。Finwave 屡获殊荣的 3DGaN 技术显著提高了 5G 毫米波系统的线性度、输出功率和效率,同时大大降低了运营商的成本。通过利用大批量 8 英寸硅 CMOS 晶圆厂生产 3DGaN 芯片,Finwave 的设备受益于硅技术的成本模型和可扩展性。
- 2023 年8 月,Veritas Capital(以下简称“Veritas”)的投资组合公司、为太空和国家安全任务提供高可靠性、先进电子解决方案的领先独立供应商Frontgrade Technologies(以下简称“Frontgrade”)今日宣布完成对Aethercomm的收购,Aethercomm是一家高功率射频(RF)固态功率放大器以及发射/接收和高功率射频开关的设计者和制造商。
- 2022年6月,创新射频和微波功率解决方案的领先供应商 Integra 今天宣布,其突破性的 100V 射频氮化镓技术已开始向美国和欧洲客户发货。Integra销售和营销副总裁Tom Kole表示:“通过与客户合作,我们的系统工程师帮助设计了新的雷达架构,充分利用了我们第三代100V RF GaN-on-SiC技术的优势。很高兴看到Integra的100V RF GaN产品与客户一起投入生产,因为这标志着另一个行业第一”。
- 射频功率放大器从地面到太空都值得信赖的射频功率放大器。Mercury行业领先的产品组合包括基于 GaN 的 SSPA 产品,可定制以支持您的关键任务应用。Mercury的专家将氮化镓 (GaN) 半导体技术应用于最棘手的射频设计问题,以尽可能小的外形尺寸实现最高的发射功率。
RF GaN领域的研究方向
射频氮化镓行业细分:GaN在射频应用中脱颖而出有几个原因,例如高击穿场、高饱和速度和强大的热特性,因为它们在长距离或高端功率水平下传输信号方面发挥了重要作用。按照行业的应用领域包括:军事、电信基础设施、卫星通信、有线宽带、商用雷达和航空电子设备以及射频能源;按照材料,碳化硅基氮化镓(GaN-on-SiC),硅基氮化镓(GaN-on-Si)。
按应用分类:
- 军事
- 电信基础设施(回程、RRH、大规模 MIMO、小型蜂窝基站)
- 卫星通信
- 有线宽带
- 商用雷达和航空电子设备
- 射频能量
按材料类型分类:
- 硅基氮化镓(GaN-on-Si)
- 碳化硅基氮化镓(GaN-on-SiC)
- 其他材料类型(GaN-on-GaN、GaN-on-Diamond)
学术界对RF GaN的研究方向主要集中在材料领域:

对RF GaN技术进行研究的机构

学术界对RF GaN的研究方向主要集中在材料领域

关于RF GaN的研究论文的发表时间
RF GaN领域的创新公司介绍
1.RF GaN领域的创新公司介绍---Tagore Technology公司

Tagore Technology公司的发展历程
Tagore Technology成立于 2011 年 1 月,是射频 (RF) 和电源管理应用的硅基氮化镓 (GaN-on-Si) 半导体技术的先驱。Tagore先进的专有技术和器件以极具竞争力的价格显著降低了系统解决方案的复杂性、尺寸、重量和功耗,与硅解决方案相比,功率转换品质因数显著提高。Tagore是一家无晶圆厂半导体公司,在美国伊利诺伊州阿灵顿高地和印度加尔各答设有设计中心。Tagore的研发团队致力于利用宽禁带技术开发颠覆性解决方案,帮助客户解决射频和电源设计挑战,并加快从5G蜂窝基础设施到消费、汽车、国防和安全等广泛应用的上市时间。Tagore与领先的半导体代工厂和组装厂合作,提供具有卓越品质和久经考验的高可靠性的产品。

Tagore Technology公司申请的专利文件

图30.Tagore Technology公司的产品和应用
2.RF GaN领域的创新公司介绍---RFHIC公司
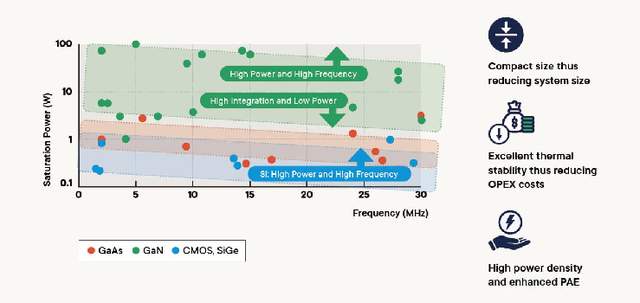
GaN器件的优势(RFHIC公司的观点)
RFHIC的使命是用射频和微波的进步来启发各行各业,以加速通过技术创新增强的未来。RFHIC代表无线电,频率,混合,集成,电路公司;RFHIC的目标是通过射频和微波的进步来启发各行各业。通过技术创新加速未来 - 利用氮化镓(GaN)射频和微波技术的力量。
几十年来,RFHIC一直在利用氮化镓在电信、国防和射频能源行业的潜力,重新构想可能性。如果可以想象,RFHIC就能实现它,速度、敏捷性和专业知识使RFHIC与众不同。
RFHIC是利用氮化镓(GaN)为无线基础设施、商业和军用雷达以及工业/科学/医疗(ISM)行业的各种应用提供射频(RF)和微波(MW)解决方案的全球领导者。

RFHIC公司的OptiGaN产品

RFHIC公司申请的专利文件
3.RF GaN领域的创新公司介绍---Integra Technologies Inc.公司

Integra Technologies Inc.公司的RF GaN器件产品
Integra 的碳化硅氮化镓 (GaN/SiC) HEMT RF 功率晶体管器件是最新的射频功率晶体管技术。它们提供从 UHF 到 C 波段微波频率的高增益和高功率水平,其碳化硅 (SiC) 衬底提供出色的散热性能,可实现长期可靠性和最佳功率密度。这套固态射频功率晶体管包括提供高达 77% 的电源效率和高达 1200 W 功率的型号。它们非常适合脉冲雷达应用中的高功率放大器 (HPA) 设计,包括商业空中交通管制 (ATC) 和军事系统。

Integra Technologies Inc.公司申请的专利文件
Integra 的集成式 GaN/SiC 射频功率放大器模块(托盘)旨在为高功率放大器设计人员提供功能强大、简单、更高级的雷达系统放大链构建模块。内置电源功能包括射频匹配、栅极脉冲和排序 (GPS)、输出噪声抑制、温度补偿和 VSWR 保护。Integra 的标准 GaN 射频功率放大器模块适用于高达 3.5 GHz 的应用,输出功率高达 2000 W,效率高达 70%,并包括各种 PCB 基板和封装选项。欢迎对 S、C 和 X 波段系统提出定制托盘和半定制设计要求。
4.RF GaN领域的创新公司介绍---HRL Laboratories

HRL Laboratories 申请的专利文件
HRL Laboratories 旨在基于传统硅半导体制造技术的氮化镓 MMIC 实现前所未有的高频性能;HRL Laboratories 的 ENIGMA 项目将最先进的硅多金属后端工艺与氮化镓晶体管单片集成,用于下一代单片微波集成电路;
HRL Laboratories, LLC 正在开发由美国国防高级研究计划局 (DARPA) 资助的高效 GaN 集成 G 波段单片阵列 (ENIGMA) 项目。ENIGMA将解决化合物半导体单片微波集成电路(MMIC)行业与硅射频集成电路(RFIC)行业之间的技术差距。
半导体器件制造需要两个关键的处理流程,称为前端和后端制造。前端是指构建晶体管的过程。后端包括制造金属互连、无源器件(电容器和电阻器)和传输线。氮化镓 (GaN) 在前端取得了巨大进步,由于击穿电压和电子速度的出色组合,MMIC 具有创纪录的输出功率和效率。然而,与硅RFIC相比,化合物半导体后端工艺很粗糙,通常只有两层金属层用于互连和传输线。其结果是大体积的设计无法满足下一代多天线阵列在高频下的密度要求。
“目前,美国政府需要非常密集的高速晶体管,专门针对220 GHz(G波段)频率,而GaN是理想的选择,”ENIGMA的HRL联合首席研究员Georges Siddiqi说。“这也是目前化合物半导体制造后端方法开始失败的地方。ENIGMA的目标是将氮化镓化合物半导体的优化晶体管与硅基RFIC的优化后端工艺相结合。通过这种方法,我们将释放更好的性能,同时保持芯片的物理尺寸”。
5.RF GaN领域的创新公司介绍---Finwave Semiconductor, Inc公司
Finwave 始于麻省理工学院 (MIT) 的突破性发现,该公司的世界领先专家团队带来了 100 多年的半导体创新经验。

Finwave Semiconductor, Inc公司改善GaN器件的线性度
Finwave 的故事始于 2012 年在麻省理工学院,当时Finwave的联合创始人 Bin Lu 博士和 Tomas Palacios 教授发明了一种基于 FinFET 架构的新型 GaN 晶体管。3D 鳍片结构正是 GaN 晶体管显著提高效率和线性度所需的。这项创新获得了 2012 年 IEEE George E. Smith 奖,不久之后,Cambridge Electronics, Inc. (CEI) 成立,将该技术推向市场。

不仅仅是5G,Finwave的GaN器件面向6G应用
经过十年的悄然改进器件性能、将晶圆尺寸从最初的 1 cm 晶圆扩大到如今采用硅兼容工艺的 8 英寸晶圆,并建立了全球合作伙伴网络,Finwave 的 GaN FinFET 正在迅速成为商业现实。为了体现从隐形技术开发到技术商业化的转变,该公司于 2022 年更名为 Finwave。Finwave 团队在沃尔瑟姆、圣地亚哥和湾区设有办事处,并在世界各地设有合作伙伴,已准备好充分发挥 5G 网络的真正潜力。

Finwave Semiconductor, Inc申请的专利文件
Finwave的RF GaN技术解锁5G的真正力量

图31.毫米波上行链路是覆盖的关键
毫米波是无线技术的未来:它的数据速率比 4G 快 100 倍,容量增加 1000 倍,延迟超低。
它有望成为未来十年技术革命最重要的推动因素。
然而,其潜力受到其非常低的 5G 无线电性能的严重限制:即使是最好的新 5G 手机,其RF无线电输出功率也比足够的上行链路连接所需的功率低 10 倍以上。5G射频芯片的电源效率也极差。
Finwave的RF GaN技术技术优势1:前所未有的线性度
Finwave 的专利方法可在器件级别对功率放大器 (PA) 和低噪声放大器 (LNA) 进行线性化,从而实现比传统技术高 10dB 以上的线性度。 这是通过减少电子捕获的“记忆”效应和新颖的器件级功率组合方法来实现的。
Finwave 3DGaN 技术的高固有线性度显著提高了复杂调制方案所需的回退条件下的 PA 效率。 此外,它还允许更简单的数字预失真 (DPD),或者可能完全消除对 DPD 的需要。
Finwave的RF GaN技术技术优势2:将摩尔定律引入 GaN
Finwave 的 3DGaN 技术在标准 8 英寸 CMOS 晶圆厂中制造,无需特殊工具。 充分利用现代铸造厂的能力,我们利用先进的光刻和 CMP 铜后端。 这与传统的化合物半导体制造有很大不同,传统的化合物半导体制造使用金、剥离和电子束光刻来实现短栅极长度器件。
Finwave 的 3DGaN 技术抑制了短沟道效应,并允许连续缩小 GaN 晶体管 - 从 8 英寸到 12 英寸,从 0.13 微米到深度缩小的晶体管,从而将摩尔定律引入 GaN。

图32.频率和技术对环境的依赖性
5G只是开始:虽然商业部署还需要很多年,但为 100GHz 以上频率的 6G 奠定基础已经做了大量工作。 深度缩放的 3DGaN FinFET 对于 6G 应用极为引人注目,其中可轻松实现超过 400 GHz Ft 和 Fmax GaN FinFET,且输出功率比其他竞争技术高出几个数量级。
除了5G/6G之外,Finwave的3DGaN技术还可以显着提高功率转换器的效率和工作频率。 Finwave正在与世界各地的合作伙伴合作,将这些创新成果应用于广泛的应用——包括从稳压器到电动汽车的一切领域。




